03 Jan WEBINAR | StrataPHI 2.0 – Updated Software for Multi-Layered Thin-Film Structure Analysis
Groot-Ammers | January 3rd, 2024

Angle-resolved X-ray photoelectron spectroscopy (AR-XPS) is a well-established technique for non-destructive analysis of compositional depth profiles, interfaces, and layer thicknesses. Traditionally, AR-XPS employs an Al Kα X-ray beam capable of probing up to 5-10 nm in depth below the surface.
DATE & TIME
📆 Tuesday, January 9th, 2024
🕔 17:00 (CET)
Alongside the recently released PHI Genesis – a fully automated multi-technique scanning X-ray microprobe incorporating Cr Kα hard X-ray photoelectron spectroscopy (HAXPES), new features have been implemented in StrataPHI 2.0 data analysis software to reconstruct quantitative, non-destructive depth profiles up to 30 nm below the surface.
In this webinar, we will discuss the basic principles behind AR-XPS and HAXPES analysis and methods for extracting non-destructive depth composition. We will also introduce three major new features in StrataPHI 2.0: 1) an ability to combine XPS and HAXPES data within a single depth profile to enhance extracted analytical information from various depths, 2) a fractional coverage analysis mode, relevant in situations where ultra-thin films exist as discrete islands, and 3) a simulation mode to allow the analyst to predict the best core-level transitions accessible by either XPS or HAXPES for data acquisition based on the ordering and thickness of individual layers in the thin-film stack. Several examples will be discussed to demonstrate such new StrataPHI capabilities.
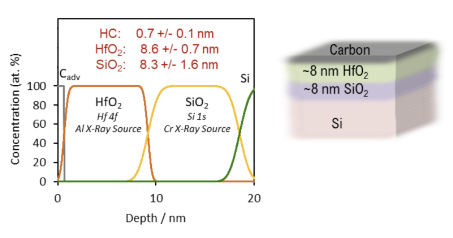
Keep me updated!
Just enter your name and email and don't miss out on all innovative technologies in the world of surface analysis.
