20 Mar WEBINAR | TOF-SIMS 102: Primary and Secondary Ion Optics and their Influences on Mass Spectrometry and Imaging
Groot-Ammers | March 20th, 2024

Time-of-flight secondary ion mass spectrometry (TOF-SIMS) is a well-established analytical technique offering unparalleled insights into surface chemistry, enabling precise analysis of molecular compositions across a diverse list of materials.
DATE & TIME
📆 Thursday, May 9th, 2024
🕔 17:00 (CET)
TOF-SIMS involves bombarding a sample’s surface with primary ions, leading to the release and analysis of secondary ions. This technique allows for parallel detection of elemental and molecular ions, the generation of high-resolution 2D and 3D images, and accurate peak identification through tandem MS. TOF-SIMS is a valuable tool for many applications in the pharmaceutical, materials science, energy, and semiconductor industries.
Join us for “TOF-SIMS 102: Primary and Secondary Ion Optics and their Influences on Mass Spectrometry and Imaging” to explore the fundamental principles of Time-of-Flight Secondary Ion Mass Spectrometry. In this webinar we will discuss the core ion optics principles integral to Physical Electronics TOF-SIMS technology, focusing on the TRIFT mass spectrometer and liquid metal ion gun optics, and how these developments impact mass spectrometry and chemical imaging.
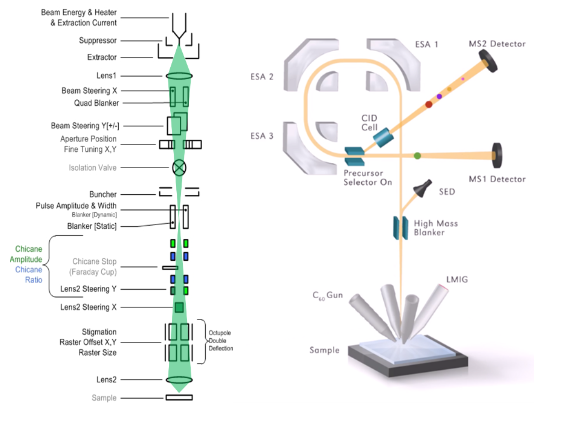
Keep me updated!
Just enter your name and email and don't miss out on all innovative technologies in the world of surface analysis.
